*当ウエブサイトにインターネットの情報源だけを使っています。*
はんだバンプとフリップチップボンディングー後工程半導体プロセス
はんだバンプ通称マイクロバンプとその未来と歴史 半導体後工程プロセスについて、書きます。
2/24/20251 分読む
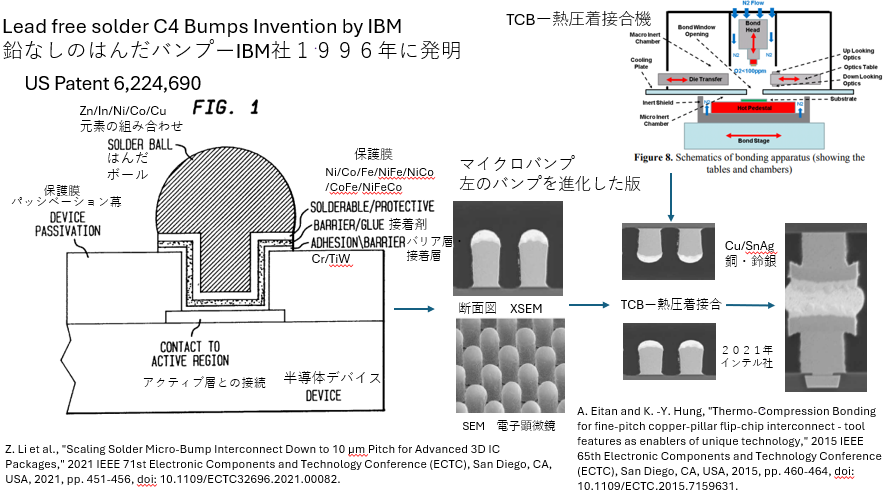
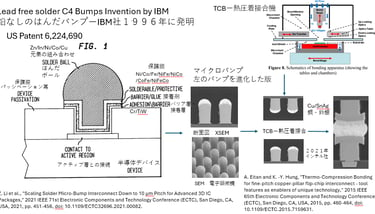
1996年代にIBM社は鉛なしのC4バンプを発明しました。でも、そのはるか前にはじめてのフリップチップデバイスはバンプを使用する初めては1964年、IBM360Model40パソコン
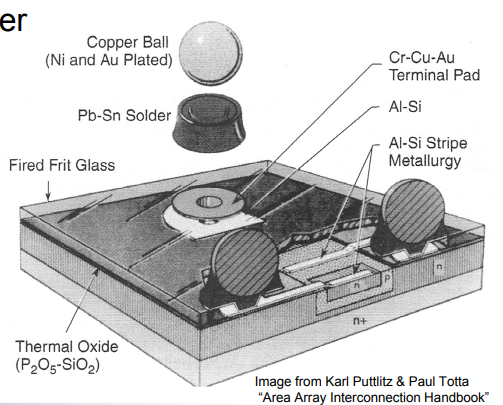
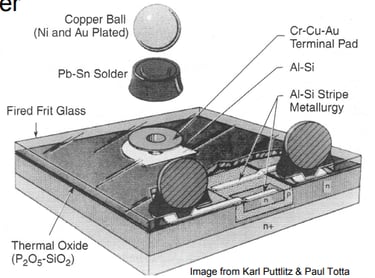
IMAPS Device Packaging Conference 2011 March, 2011により:
三つの銅のボール、350マイクロンバンプでした(C2)。 現在最も優れている技術では、40マイクロン以下のピッチ(バンプとバンプとの間)とサイズは25マイクロンです。昔の技術の話に戻ると、PbSnのはんだを使っていた。ワイヤーボンドから変わってて、なぜなら、その昔で人が顕微鏡に通じてワイヤボンドを人の手でアラインメントしました。バンプなら、もっと強いです。左下の写真はIBMでその当時のパソコン写真。トランジスタとメモリー部分。
軽く他の歴史をふると、C4を70年代から使い始めて、日立社は1981年代に電解メッキプロセスを使うバンプの論文を発表。使っていた金属はチタン、ニッケルと銅。現在とバンプと一致している材料です。1984年に日立はアンダーフィルをフリップチップのセラミックの信頼性のために発明。バンプの間にアンダーフィルの材料は投入されます。時間と共に、バンプのピッチは徐々に進化しました。2011インテルが32ナノのプロセスノードの図は下に表示してます。


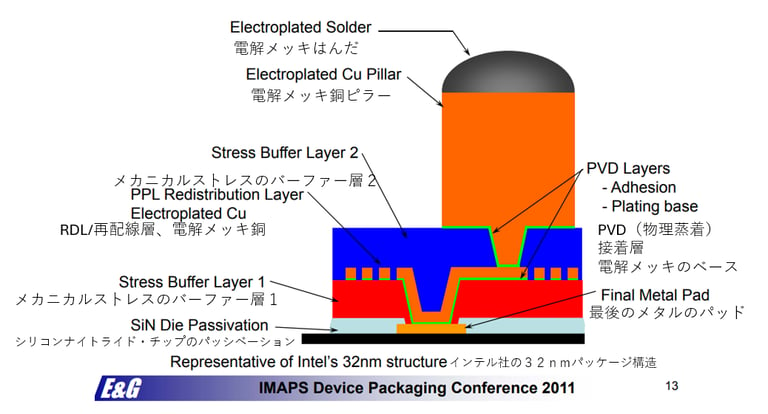
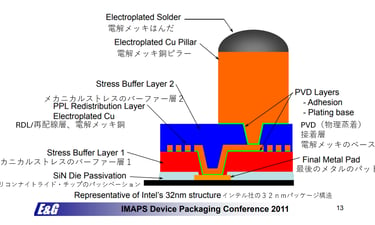
超音波熱圧着:
TCB - thermocompression bonding -
熱圧着接合機
フレキスブルのサーキットの熱圧接合機の映像
国内開発のフリップチップボンダーの機械
ヤマハ社ーYSB55w
*この題目にたくさんの研究発表と論文が書かれており、詳細な記事を完全に書くのは時間がかかります。予めご理解を頂ければ幸いでございます。*
https://www.youtube.com/watch?v=gFgmnEguVSQ
https://www.youtube.com/watch?v=78s148IR2gg
https://www.evgroup.com/products/bonding/permanent-bonding-systems/evg501
https://www.youtube.com/shorts/mQP9J4iYYtA
https://www.mdpi.com/2073-4352/13/7/989
https://ieeexplore.ieee.org/document/8811172
https://www.youtube.com/watch?v=zyL9w-SyhZw
https://www.youtube.com/watch?v=ekolKMigeQo
https://www.youtube.com/watch?v=PA49Drm-asM
https://www.youtube.com/watch?v=_ZyL0_3WrNA
https://www.youtube.com/watch?v=pigf04h7PEY
https://site.ieee.org/ocs-cpmt/files/2013/06/Solder-Bump-vs.-Copper-Pillar_ver3.pdf
https://www.youtube.com/watch?v=Xt0So1S76L0
https://sst.semiconductor-digest.com/2001/03/c4-makes-way-for-electroplated-bumps/
https://www.circuitnet.com/news/uploads/1/Copper_Pillar_App_rev2.pdf
https://lintar.untar.ac.id/repository/penelitian/buktipenelitian_10387042_3A120921113347.pdf
http://www.meptec.org/Resources/11%20-%20Hayes.pdf
https://amicra.semi.asmpt.com/en/applications/3d-ic-tsv-and-tcb/
https://pmc.ncbi.nlm.nih.gov/articles/PMC9965429/
https://www.youtube.com/watch?v=IfX9Qn7p9-M
Music
Raymond Doerr is an engineer in the electronics industry, composer, and violinist
Violin
Blog
123-456-7890
© 2024. All rights reserved.
